新型SiC芯片可用IPM、TPAK方式封装,以应用于电动车逆变器SiC导线架技术为例,导线架Copper Clip和SiC芯片连接采用烧结银AS9385连接技术,
可实现高可靠、高导电的连接的需求,很多Tier 1的控制器公司和Tier 2功率模组制造商,在汽车模组中均或多或少的采用该烧结银DTS技术,
在成型技术也相当困难,由于电镀银是局部镀银,相较于全镀,部分镀银技术很难,做模具,且放置芯片处用局部银,一个导线架搭两个芯片,芯片局部银,其他引线框架用镍钯金,材料差异对引线框架制作是很大的技术挑战。
单管封装中引入扩散焊“Diffusion Soldering”,省了芯片与lead frame之间的焊料,优化了器件热阻。以1200V/30mOhm的SiC MOSFET单管为例,基于GVF预烧结银焊片,相比当前焊接版的TO247-3/4L,可降低约25%的稳态热阻Rth(j-c),和约45%的瞬态热阻。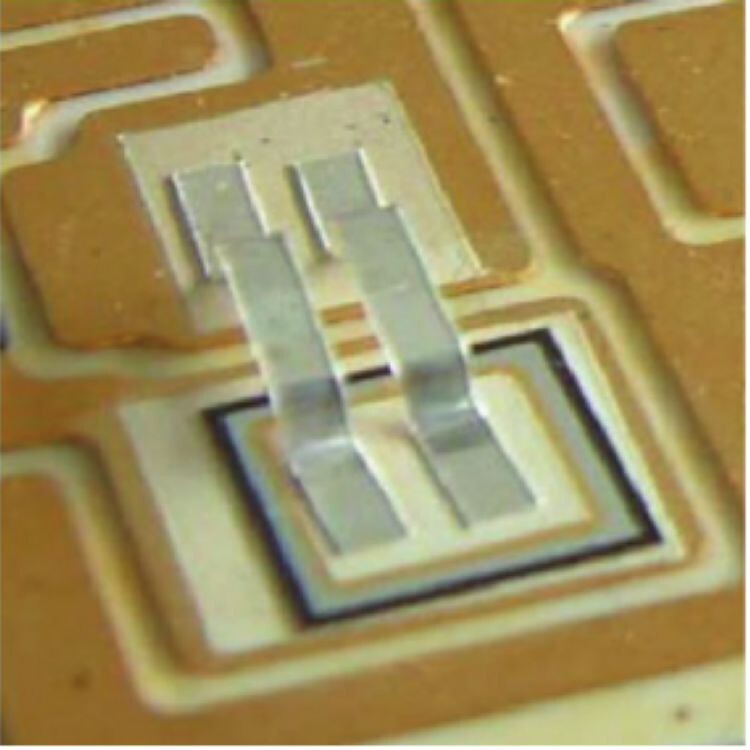
GVF预烧结银焊片(DTS+TCB(Die Top System +Thick Cu Bonding))能够将电力电子模块的使用寿命延长50多倍,并确保芯片的载流容量提高50%以上。
SHAREX的预烧结银焊片GVF9800(DTS+TCB(Die Top System +Thick Cu Bonding)是结合了烧结银,铜箔和其他材料的一种复合材料,由以下四个部分组成:具有键合功能的铜箔;预涂布AS9385系列烧结银;烧结前可选用临时固定的胶粘剂;保护膜或者承载物。